芯片封装,成为主角
先进的封装技术意味着提供芯片分割的解决方案。先进封装的想法大概可以追溯到英特尔成立之前。戈登·摩尔(英特尔创始人之一)表示,“用小型、单独封装和互连的功能构建大型系统可能会被证明是经济的。”他说。

事实上,在当前的系统中,许多单独封装的组件是互连的。另一方面,称为 SoC 的半导体架构将许多功能集成到一个封装中。
当今的 SoC 需要多样化的功能和工作负载处理性能,因此很难将它们集成到单个芯片中。许多半导体制造公司也用单片硅生产大型产品,但这些产品通常是在尖端工艺节点制造的,因此成本高昂。
另一方面,如果将它们分开,仅靠传统的封装技术将无法成功地将它们商业化。英特尔之所以能够将 PCH 封装在 CPU 内部,是因为它通过传统封装设计了解散热、带宽、功率要求和硅成本。
先进封装是从SoC概念中增加集成度向在封装上配置系统的转变,是与延续摩尔定律的小型化+单片硅不同的做法。

回顾标准封装的历史,英特尔于 2013 年首次在一个封装内集成了两种不同类型的功能,代号为 Haswell。当时,使用一种称为封装内 IO (OPIO) 的技术来集成在封装上,用于连接平台控制器中枢和 SoC。
OPIO 还被用于功能集成,例如连接封装上的 eDRAM(嵌入式 DRAM)以及其他客户端封装。它还用于集成 SoC 和 PCH 封装,代号为 Alder Lake 和 Raptor Lake,并且是制造它们的合适封装技术。
然而,Haswell 不需要tile(chiplet)一代的可扩展性,没有那么多的带宽或密度,并且需要高功率效率,需要使用EMIB/Foveros封装技术进行芯片集成。但当时没有。
这就是传统的MCP(多芯片封装)。接下来我们就来总结一下目前备受关注的最新封装技术。
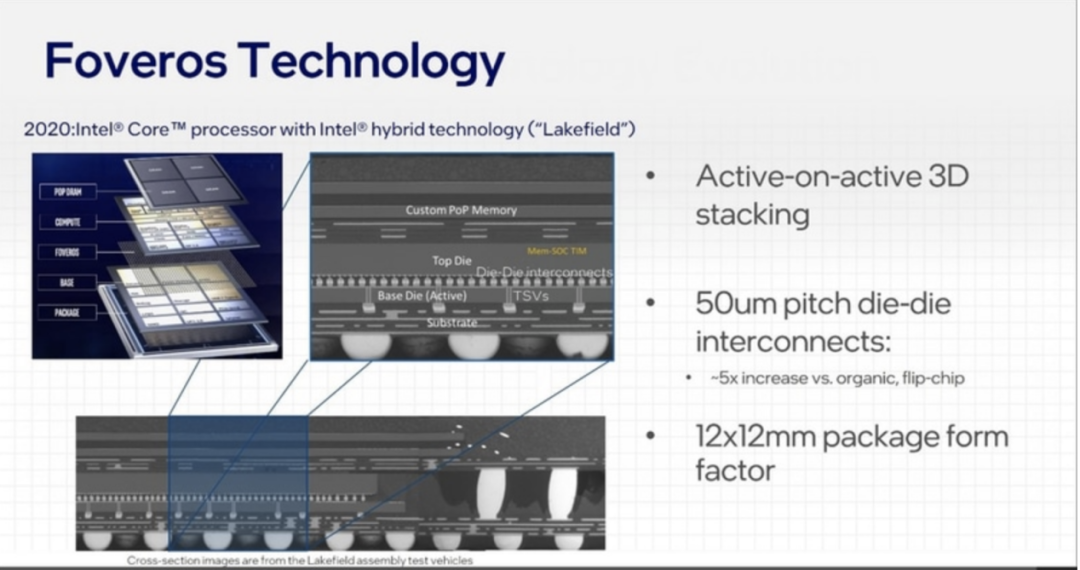
EMIB:嵌入式多芯片互连桥
可以说,EMIB技术是向先进封装过渡的第一支柱。EMIB 代表嵌入式多芯片互连桥,是一种通过将硅桥嵌入到基板中来实现两块硅之间高密度互连的技术。
请看上面幻灯片中的照片。在此横截面中,您可以看到桥接硅片与连接测试块的块之间通过 EMIB 进行互连。
EMIB 硅非常薄。该公司目前正在实现间距为 55 μm 的互连,这大约是有机倒装芯片封装当前基准密度的五倍。
2017 年第一个使用 EMIB 商业化的产品是 FPGA 产品。但第一个使用 EMIB 量产的产品代号为 Sapphire Rapids。EMIB 使得制造比掩模版(曝光掩模)中使用的硅大三倍以上的芯片成为可能,并且 Sapphire Rapids 被用作数据中心的处理器。
Foveros
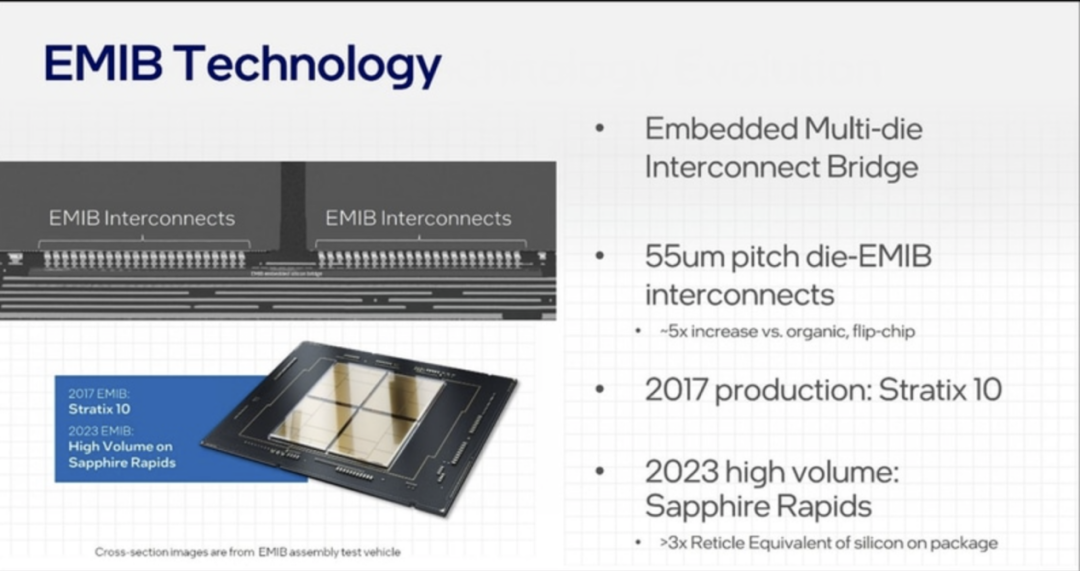
技术发展的下一步将是 Foveros。该项目的开发也是从 2017 年开始的。
Foveros 是一种新的互连技术。您可以在上图中看到第一个 Foveros 的横截面。您可以看到顶部tile位于基础tile(芯片或小芯片)上,每个tile都通过硅通孔连接到封装基板,从而允许与封装进行信号通信。
这里的tile间互连具有 50μm 节距,与 EMIB 非常相似。这也意味着互连密度比有机倒装芯片高约五倍。第一个使用该技术的产品代号为 Lakefield。
这是业界第一个真正的 3D 核心堆栈,位于 Uncore(核心硅除外)之上,占用空间极小。具体来说,Foveros 技术实现了 12x12mm 的占地面积。它还实现了堆叠在封装内部的叠封装存储器。
CO-EMIB:Foveros+EMIB

它被称为 Co-EMIB,下一代封装技术。Co-EMIB 是一项结合了 Foveros 和 EMIB 的技术。这允许更高的包可扩展性。您可以在封装上进行纵向扩展(更大的面积 = 2D 中更宽)和横向扩展(更小的占用空间 = 3D 中堆叠),所有这些都可以通过高密度和高带宽互连来实现。这项技术被用在Intel的GPU Ponte Vecchio上。
然而,Co-EMIB并不是在Lakefield实现商业化的Foveros和在Sapphire Rapids和FPGA实现商业化的EMIB的简单组合。首先,Foveros 已大幅扩展,互连间距从 50μm 增至 36μm。Lakefield)面积约为 100 平方毫米,而Ponte Vecchio则已扩大到超过 600 平方毫米。
另一个演变是Ponte Vecchio的每个底座die都有多个相互堆叠的tile,正如您在上面的金色tile照片中看到的那样。这种多块tile的堆叠也是一种演变。
Lakefield 在一个基础芯片之上有一个计算芯片,而 POP 内存则在其之上。另一方面,Ponte Vecchio 将英特尔和外部代工厂块连接到单个基础芯片上。
这已成为该行业有史以来最复杂的情况。事实上,它包含 11 个桥、47 个有源块、5 个处理节点和超过 1000 亿个晶体管。这超过 1000 亿个晶体管数量不包括 HBM。还有三块大面积硅片,尺寸是传统掩模版的三倍多,全部封装在一个封装中。
上面我已经解释了封装技术。传统的多芯片封装长期以来一直用于将 CPU 和 PCH 集成在一个封装上,但从这里开始的演变是向平铺结构发展,以提供更多功能和提高性能。我认为我们明白演变是必要的。
这里介绍的新封装技术最近才应用于量产产品,相信它将成为支撑未来封装技术演进的基础。未来,封装技术还需要大量投资。换句话说,在新型半导体的开发中,不仅晶圆晶体管制造技术,封装技术也将成为投资重点。
本文来源网络,如有侵权,请联系删除!

